晶圆级CSP的返修完成之后的检查
[09-12 18:49:32] 来源:http://www.88dzw.com PCB设计 阅读:8822次
文章摘要:返修之后可以对重新装配的元件进行检查测试,检查测试的方法包括非破坏性的检查方法,如目视、光 学显微镜、电子扫描显微镜、超声波扫描显微镜、X-Ray和一些破坏性的检查测试,如切片和染色实验、老 化和热循环测试,以及机械测试(推拉,跌落,振动,扭转和弯曲)等。例如,可以用X-Ray检查返修前后 焊点的情况,是否短路,在焊点内是否有空洞存在等。如图1所示。图1 X-Ray检查返修前后的焊点对焊点切片后,利用显微镜检查焊点内空洞的情形,检查其是否润湿良好等。如图2所示。图2 对焊点切片检查,因为底部填充材料残留,导致焊接过程中润湿不良利用上面介绍的关于非破坏性和破坏性的检查方法,可以确定返修工艺是否可
晶圆级CSP的返修完成之后的检查,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com返修之后可以对重新装配的元件进行检查测试,检查测试的方法包括非破坏性的检查方法,如目视、光 学显微镜、电子扫描显微镜、超声波扫描显微镜、X-Ray和一些破坏性的检查测试,如切片和染色实验、老 化和热循环测试,以及机械测试(推拉,跌落,振动,扭转和弯曲)等。例如,可以用X-Ray检查返修前后 焊点的情况,是否短路,在焊点内是否有空洞存在等。如图1所示。
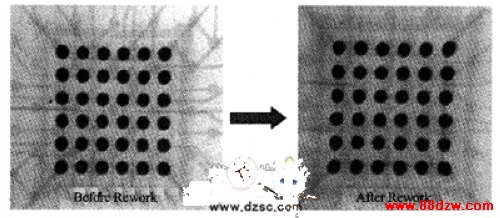
图1 X-Ray检查返修前后的焊点
对焊点切片后,利用显微镜检查焊点内空洞的情形,检查其是否润湿良好等。如图2所示。

图2 对焊点切片检查,因为底部填充材料残留,导致焊接过程中润湿不良
利用上面介绍的关于非破坏性和破坏性的检查方法,可以确定返修工艺是否可靠,还可以开发和优化返修工艺,以获得满意的良率和可靠性。
欢迎转载,信息来源www.88dzw.com(www.88dzw.com)
Tag:PCB设计,pcb培训,pcb是什么,pcb软件,PCB设计
《晶圆级CSP的返修完成之后的检查》相关文章
- › 晶圆级CSP的返修完成之后的检查
- › 晶圆级CSP的元件的重新贴装及底部填充
- › 晶圆级CSP的焊盘的重新整理
- › 晶圆级CSP的返修工艺
- › 晶圆级CSP装配的底部填充工艺
- › 晶圆级CSP装配回流焊接工艺控制
- 在百度中搜索相关文章:晶圆级CSP的返修完成之后的检查
- 在谷歌中搜索相关文章:晶圆级CSP的返修完成之后的检查
- 在soso中搜索相关文章:晶圆级CSP的返修完成之后的检查
- 在搜狗中搜索相关文章:晶圆级CSP的返修完成之后的检查
分类导航
最新更新




 当前位置:
当前位置: