高速HDI电路板设计过程的考虑(推荐)
[08-09 20:40:07] 来源:http://www.88dzw.com CAD CAM 阅读:8653次
文章摘要: 元件尺寸 焊料球/焊料柱 图2-2描述了一些新的面积阵列元件,这些元件要求采用微孔工艺实现信号的有效传输。左侧是384个引脚焊料球、0.8mm间距的uBGA器件,右侧是1247个引脚焊料柱、1.0mm间距的CCGA(Ceramic Column Grid Array)器件。 Fig2-2 具有更高I/O数和更精细间距的新型BGA 2.3 基材的考虑 高性能多层板的基材特性是首要考虑的因素。下述黑体部分的5个基材特性与其它设计因素相互影响。 板厚 介电常数(Dk) 耗散因素(Dj)/介质损耗角 线性热膨胀系数(CTE)
高速HDI电路板设计过程的考虑(推荐),标签:CAD教程,CAM资料,http://www.88dzw.com元件尺寸
焊料球/焊料柱
图2-2描述了一些新的面积阵列元件,这些元件要求采用微孔工艺实现信号的有效传输。左侧是384个引脚焊料球、0.8mm间距的uBGA器件,右侧是1247个引脚焊料柱、1.0mm间距的CCGA(Ceramic Column Grid Array)器件。

Fig2-2 具有更高I/O数和更精细间距的新型BGA
2.3 基材的考虑
高性能多层板的基材特性是首要考虑的因素。下述黑体部分的5个基材特性与其它设计因素相互影响。
板厚
介电常数(Dk)
耗散因素(Dj)/介质损耗角
线性热膨胀系数(CTE)
玻璃转变温度(Tg)
介电常数(Dk)和耗散因素是影响电气性能最主要的两个特性。从图2-3可知,许多不含环氧材料的树脂可被采用,也可使用多种类型的增强纤维材料(包括不含增强材料的背胶铜箔(RCF―Resin Coated Foil))。前述的两个因素的结合决定了基材的介电性能,树脂也有典型的玻璃转变温度――Tg值。图2-4列举了一些典型的高性能材料。

Fig2-3 不同类别的新型介电质与高性能树脂和增强材料比较

Fig2-4 应用于有机基板的不同类型的树脂纤维电气性能一览表
2.4 叠层的考虑
板的叠层和设计规则的不确定性对印制电路板生产商有一定的影响,这就要求控制在生产商的生产能力范围内否则设计目标无法达到。如下因素至关重要:
板厚
VIP工艺
设计规则
过孔结构
突破模式
采用微孔工艺的VIP技术很容易达到8mil(0.2mm)的焊盘,要比埋孔大一些。图2-5说明了该情况下的设计规则,即信号层和设计规则所确定的传输线路的容量要比元件和电路要求的传输线路的容量大。
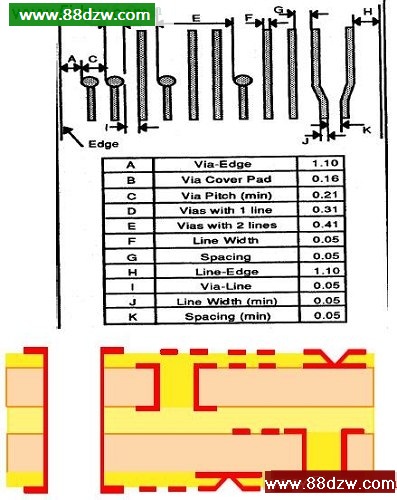
Fig 2-5 线路容量图示
现实中有许多预测线路需求的模型,下面提供了八类常用的模型:
HP''s Design Dense Index
Toshiba Technology Map
Equivalent Ics Per Square Inch
Coors,Anderson & Seward''s Statistical Wiring Length Technique
Rent''s Rule Techniques
Section Crossing Technique
Geometric Approach
- 上一篇:PCB尺寸和外形的设计
《高速HDI电路板设计过程的考虑(推荐)》相关文章
- › 高速HDI电路板设计过程的考虑(推荐)
- 在百度中搜索相关文章:高速HDI电路板设计过程的考虑(推荐)
- 在谷歌中搜索相关文章:高速HDI电路板设计过程的考虑(推荐)
- 在soso中搜索相关文章:高速HDI电路板设计过程的考虑(推荐)
- 在搜狗中搜索相关文章:高速HDI电路板设计过程的考虑(推荐)




 当前位置:
当前位置: