倒装晶片的非流动性底部填充工艺
[09-12 18:50:16] 来源:http://www.88dzw.com PCB设计 阅读:8391次
文章摘要:图5 155℃温度下加热35 s气泡消失回流焊接及圃化过程是另一需要控制的重点。在同一回流焊接炉内,必须先完成焊接,然后胶水才能固化 。由于在焊接过程中,元件离板高度有一定程度的降低,所以胶水此时要能够流动。一般胶水的固化温度在165℃左右,固化时间为5~30 min,对于固化时间要求比较长的材料,在过完回流 炉之后还需要再次加热,保证填料完全固化。在选择非流动性底部填充材料时,要充分考虑其固化温度曲线 和焊接温度曲线兼容性的问题,助焊剂活化温度和回流焊接温度高的温度曲线与固化温度低或固化时间短的 温度曲线兼容性就差,此时工艺窗口很窄,要获得满意的装配良率会比较困难。那么,该如何获得我们所需
倒装晶片的非流动性底部填充工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com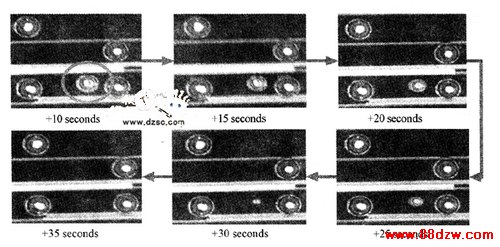
图5 155℃温度下加热35 s气泡消失
回流焊接及圃化过程是另一需要控制的重点。在同一回流焊接炉内,必须先完成焊接,然后胶水才能固化 。由于在焊接过程中,元件离板高度有一定程度的降低,所以胶水此时要能够流动。
一般胶水的固化温度在165℃左右,固化时间为5~30 min,对于固化时间要求比较长的材料,在过完回流 炉之后还需要再次加热,保证填料完全固化。在选择非流动性底部填充材料时,要充分考虑其固化温度曲线 和焊接温度曲线兼容性的问题,助焊剂活化温度和回流焊接温度高的温度曲线与固化温度低或固化时间短的 温度曲线兼容性就差,此时工艺窗口很窄,要获得满意的装配良率会比较困难。那么,该如何获得我们所需 要的温度曲线昵?可以通过以下步骤来优化焊接及固化温度曲线(如图6和图7所示):
①板上元件全部装配,然后取得感兴趣元件的温度曲线,这就是你的参考基准曲线;
②只贴装倒装晶片,取得温度曲线,这是温度高的曲线;
③将基线的每个温区温度下降5℃得到温度最低的曲线;
④在参考基准曲线和高温曲线间设置一温度曲线,在参考基准曲线和低温曲线间设置一温度曲线;
⑤用以上每种温度曲线组装样品,以电气测试、X射线仪、声波扫描仪和切片等方法检查是否有焊点畸形、 开路、冷焊、桥连及气泡等;
⑥选择焊接及固化效果最好的一种温度设置。
使用温度最低的曲线时要留意填料是否固化,可以使用声波扫描和切片检查元件底部填料中是否有“空洞”存在 并有蔓延的微裂纹。

图6 通过高温曲线,标准曲线及低温曲线来优化焊接及固化温度设置

图7 在回流炉中焊球完全熔化并润湿焊盘,在此过程完成之前填料仍然可以流动
欢迎转载,信息来源www.88dzw.com(www.88dzw.com)
Tag:PCB设计,pcb培训,pcb是什么,pcb软件,PCB设计
- 上一篇:双模块复合式结构贴片机
《倒装晶片的非流动性底部填充工艺》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的非流动性底部填充工艺
- 在谷歌中搜索相关文章:倒装晶片的非流动性底部填充工艺
- 在soso中搜索相关文章:倒装晶片的非流动性底部填充工艺
- 在搜狗中搜索相关文章:倒装晶片的非流动性底部填充工艺
分类导航
最新更新




 当前位置:
当前位置: