倒装晶片的底部填充工艺
[09-12 18:50:07] 来源:http://www.88dzw.com PCB设计 阅读:8681次
文章摘要:底部填充工艺就是将环氧树脂胶水点涂在倒装晶片边缘,通过“毛细管效应”,胶水被吸往元件的对侧完成底 部充填过程,然后在加热的情况下胶水固化。为了加快胶水填充的速度,往往还需要对基板进行预热。利用“毛 细管效应”进行底部填充的工艺分为以下几个步骤:・基板预热;・分配填料(点胶):・毛细流动;・加热使填料固化。为什么倒装晶片焊接完后都需要进行底部填充呢?我们来看焊接完成之后组件中材料,其中有电路板、元器件 和电路板材料为有机材料,如环氧树脂玻璃纤维加强材料、铜焊盘及线路、焊盘上其他金属和阻焊膜,而元件基 材是硅,还有金属焊球。所有这些材料热膨胀系数都不一致,稍微的热变形可能会造成组件内应力集中的现象
倒装晶片的底部填充工艺,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com底部填充工艺就是将环氧树脂胶水点涂在倒装晶片边缘,通过“毛细管效应”,胶水被吸往元件的对侧完成底 部充填过程,然后在加热的情况下胶水固化。为了加快胶水填充的速度,往往还需要对基板进行预热。利用“毛 细管效应”进行底部填充的工艺分为以下几个步骤:
・基板预热;
・分配填料(点胶):
・毛细流动;
・加热使填料固化。
为什么倒装晶片焊接完后都需要进行底部填充呢?我们来看焊接完成之后组件中材料,其中有电路板、元器件 和电路板材料为有机材料,如环氧树脂玻璃纤维加强材料、铜焊盘及线路、焊盘上其他金属和阻焊膜,而元件基 材是硅,还有金属焊球。所有这些材料热膨胀系数都不一致,稍微的热变形可能会造成组件内应力集中的现象, 由于倒装晶片组件的焊点非常小,很容易在此过程中破裂。之所以需要底部填充是因为倒装晶片组件:
①材料之间热膨胀系数不匹配;
②弯曲变形可能造成失效;
③跌落/冲击/机械振动造成失效;
④静态负荷,如散热片工作产生的热量导致失效;
⑤需要提高热循环寿命。
底部填充分为基于毛细流动的底部填充和预先施加胶水的非流动性底部填充工艺.
在图1中,因未进行底部填充,SnPb焊点出现疲劳裂纹。

图1 SnPb焊点,未进行底部填充,出现疲劳裂纹
图2 是倒装晶片底部填充材料特性与结构示意图。
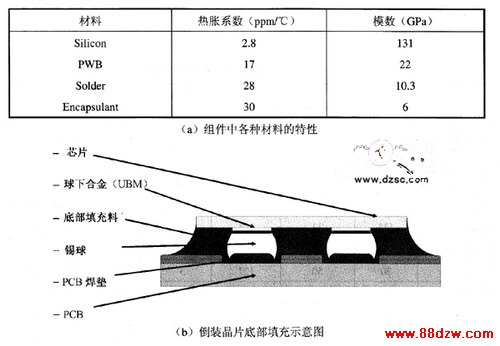
图2 倒装晶片底部填充材料特性与结构示意图
(1)底部填充工艺对于填充材料的要求
对于填充材料的特性,我们要求:
①流动性要好,同时有比较好的润湿能力,能够适应最小的间隙,在流动过程中不容易产生气泡,有较好的形 成圆角的能力。
②固化条件能够和现有的生产工艺流程相匹配。较长的固化时间可能会成为生产线的瓶颈。
③良好的可靠性,譬如,・较高的玻化温度(Tg),与组件相匹配的热膨胀系数(CTE)等。
④与助焊剂有良好的兼容性。有时由于材料选择不当,助焊剂和填充材料之间会产生交互反应,使产品可靠性 迅速降低。
⑤组装完成后,组件能够承受长时间的老化,并且暴露在湿汽中功能和可靠性不受影
响。
⑥组件可以通过无铅湿敏度测试(JEDEC,Level 3)。
在实际应用中,我们该如何选择底部填充材料呢?填充材料的选择是与产品特点相关的,往往需要在工艺和可 靠性间平衡。以下是我们在选择材料时考虑的因素:
・基板材料的不同,硬质板和柔性板要求底部填充材料热膨胀系数会不一样。
・晶片尺寸的大小及离板的间隙会影响胶水在底部流动的速度,较大的元件需要流动速度较快的填充材料,要 考虑填充材料的流动速度是否成为瓶颈。
・填充材料在小的间隙中是否具有合理的流动速度。一般材料都会界定最小的填充间隙,在选择时需要考虑产 品的最小间隙是否满足要求。
・填充材料在小的间隙中流动是否会容易产生气泡,气泡的存在会降低产品的可靠性。
・底部填充材料对上下两侧材料的润湿力是否相近,如果差异太大,会造成流动不完整,或产生气泡。
・填充材料自动形成圆角的能力要强,其对元件基材具有良好的润湿能力,一部分填充材料要能够自动爬至元件 的四个侧面形成圆角。
一些底部填充材料的特性如表1所示。
表1 一些底部填充材料的特性
- 上一篇:拱架式贴片机结构
《倒装晶片的底部填充工艺》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的底部填充工艺
- 在谷歌中搜索相关文章:倒装晶片的底部填充工艺
- 在soso中搜索相关文章:倒装晶片的底部填充工艺
- 在搜狗中搜索相关文章:倒装晶片的底部填充工艺




 当前位置:
当前位置: