倒装晶片的回流焊接及填料固化后的检查
[09-12 18:50:19] 来源:http://www.88dzw.com PCB设计 阅读:8209次
文章摘要:对完成底部填充以后产品的检查有非破坏性检查和破坏性检查,非破坏性的检查有:・利用光学显微镜进行外观检查,譬如,检查填料在元件侧面爬升的情况,是否形成良好的边缘圆角,元件表面 是否有脏污等;・利用X射线检查仪检查焊点是否短路、开路、偏移,以及润湿情况,焊点内是否出空洞等;・电气测试(导通测试),可以测试电气联结是否有问题,对于一些采用菊花链设计的测试板,通过通短测试还 可以确定焊点失效的位置;・利用超声波扫描显微镜(C-SAM)检查底部填充后其中是否有空洞,分层和流动是否完整。破坏性的检查可以对焊点或底部填料进行切片,结合光学显微镜、金相显微镜或电子扫描显微镜和能谱分析仪( SEM/EDX),检
倒装晶片的回流焊接及填料固化后的检查,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com对完成底部填充以后产品的检查有非破坏性检查和破坏性检查,非破坏性的检查有:
・利用光学显微镜进行外观检查,譬如,检查填料在元件侧面爬升的情况,是否形成良好的边缘圆角,元件表面 是否有脏污等;
・利用X射线检查仪检查焊点是否短路、开路、偏移,以及润湿情况,焊点内是否出空洞等;
・电气测试(导通测试),可以测试电气联结是否有问题,对于一些采用菊花链设计的测试板,通过通短测试还 可以确定焊点失效的位置;
・利用超声波扫描显微镜(C-SAM)检查底部填充后其中是否有空洞,分层和流动是否完整。
破坏性的检查可以对焊点或底部填料进行切片,结合光学显微镜、金相显微镜或电子扫描显微镜和能谱分析仪( SEM/EDX),检查焊点的微观结构,譬如,微裂纹/微孔、锡结晶、金属间化合物(IMC)、焊接及润湿情况,底部 填充是否有空洞和裂纹,分层和流动是否完整等。
完成回流焊接及底部填充工艺后的产品常见缺陷有:焊点桥连/开路、焊点润湿不良、焊点空洞/气泡、焊 点开裂/脆裂、底部填料和晶片分层,以及晶片破裂等。对于底部填充是否完整和填料内是否出现空洞,以 及裂纹和分层现象,需要超声波扫描显微镜(C-SAM)或通过与晶片底面平行的切片(Hat Section)结合 显微镜才能观察到,这给检查此类缺陷增加了难度。
底部填充材料和晶片之间的分层往往发生在应力最大的元件的4个角落处或填料与焊点的界面,如图1、图 2、图3和图4所示。

图1 平行元件底面切片检查到底部填料开裂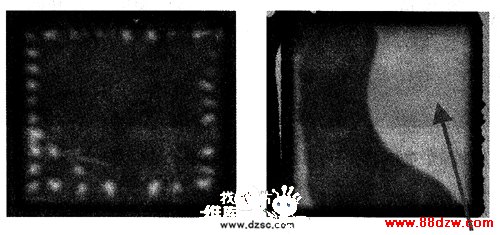
图2 利用超声波扫描显微镜观察到填料与晶片分层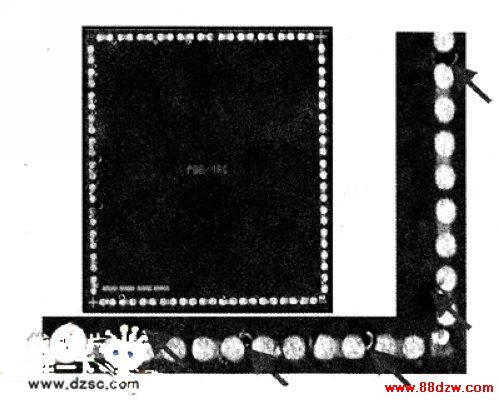
图3 平行元件底面切片检查到底部填料空洞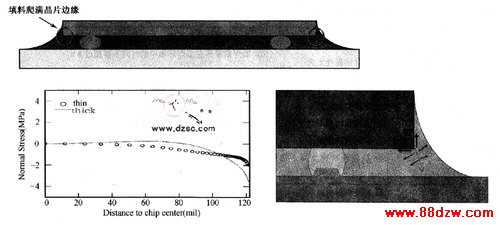
图4 应力在晶片与密封材料界面的分布→在边角处显著集中
由于倒装晶片的焊点很小,0.1 mm的焊球焊接完成后约为0.075 mm,往往其中一旦有空洞都会是比较大的 空洞,这会影响到焊点的机械连接强度、晶片的散热以及产品的电气性能,所以应尽量避免焊点中大的空洞 。对于空洞的允收标准可以遵循IPC相关标准,但是值得注意的是,需要观察空洞在焊点中分布的位置,有 时会发现有连串的小空洞排列在焊接面与焊点本体的界面,或有些临近焊点中应力最大的位置如焊点的角落 处,这些空洞不一定超出IPC的规定,但由于其所处位置很容易导致裂纹迅速生长,导致焊点过早失效,所 以也应该将其列为不良之列。
焊点内空洞形成的原因有多种,归纳起来有以下几种:
・助焊剂在回流过程中受高温分解进入焊点:
・由于一部分助焊剂在回流焊接过程中挥发,进入焊点从而形成气泡;
・在锡膏系统中,溶剂和添加剂在焊接过程中蒸发而形成气泡;
・由于助焊剂与金属焊盘、焊球及锡粉颗粒表面氧化层发生化学反应而使气体进入焊点;
・PCB中的水汽蒸发参与了焊接过程当中;
・焊接过程中液态焊料周围中的空气进入到了焊点中:
・金属焊盘受到有机物污染(如指印等),在焊接过程中分解进入焊点。
了解造成各种缺陷的根本原因,有利于我们采取得当的措施来解决及预防各种可能出现的缺陷。表1列出 的是在倒装晶片组装工艺中常见的缺陷及原因分析,并针对各缺陷提出了改善措施,以方便工程技术人员在 工艺过程中快速有效地找出问题的根本原因,帮助采取正确的解决或预防方法。
- 上一篇:转塔式贴片机
《倒装晶片的回流焊接及填料固化后的检查》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的回流焊接及填料固化后的检查
- 在谷歌中搜索相关文章:倒装晶片的回流焊接及填料固化后的检查
- 在soso中搜索相关文章:倒装晶片的回流焊接及填料固化后的检查
- 在搜狗中搜索相关文章:倒装晶片的回流焊接及填料固化后的检查




 当前位置:
当前位置: