倒装晶片的组装工艺流程
[09-12 18:49:02] 来源:http://www.88dzw.com PCB设计 阅读:8759次
文章摘要:1.一般的混合组装工艺流程在半导体后端组装工厂中,现在有两种模块组装方法。在两次回流焊工艺中,先在单独的SMT生产线上组装SMT 元件,该生产线由丝网印刷机、芯片贴装机和第一个回流焊炉组成。然后再通过第二条生产线处理部分组装的模 块,该生产线由倒装芯片贴片机和回流焊炉组成。底部填充工艺在专用底部填充生产线中完成,或与倒装芯片生 产线结合完成。如图1所示。图1 倒装晶片装配的混合工艺流程2.倒装晶片的装配工艺流程介绍相对于其他的IC元件,如BGA和CSP等,倒装晶片装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工 艺。因为助焊剂残留物(对可靠性的影响)及桥连的危险,将倒装芯片贴装于锡膏上不
倒装晶片的组装工艺流程,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com1.一般的混合组装工艺流程
在半导体后端组装工厂中,现在有两种模块组装方法。在两次回流焊工艺中,先在单独的SMT生产线上组装SMT 元件,该生产线由丝网印刷机、芯片贴装机和第一个回流焊炉组成。然后再通过第二条生产线处理部分组装的模 块,该生产线由倒装芯片贴片机和回流焊炉组成。底部填充工艺在专用底部填充生产线中完成,或与倒装芯片生 产线结合完成。如图1所示。

图1 倒装晶片装配的混合工艺流程
2.倒装晶片的装配工艺流程介绍
相对于其他的IC元件,如BGA和CSP等,倒装晶片装配工艺有其特殊性,该工艺引入了助焊剂工艺和底部填充工 艺。因为助焊剂残留物(对可靠性的影响)及桥连的危险,将倒装芯片贴装于锡膏上不是一种可采用的装配方法 。业内推出了无须清洁的助焊剂,晶片浸蘸助焊剂工艺成为广泛使用的助焊技术。目前主要的替代方法是使用免 洗助焊剂,将元件浸蘸在助焊剂薄膜里让元件焊球蘸取一定量的助焊剂,再将元件贴装在基板上,然后回流焊接 ,或者将助焊剂预先施加在基板上,再贴装元件与回流焊接。助焊剂在回流之前起到固定元件的作用,回流过程 中起到润湿焊接表面增强可焊性的作用。倒装晶片焊接完成后,需要在元件底部和基板之间填充一种胶(一般为 环氧树脂材料)。底部填充分为基于“毛细流动原理”的流动性和非流动性(No-follow)底部填充。
上述倒装晶片组装工艺是针对C4元件(元件焊凸材料为SnPb,SnAg,SnCu或SnAgCu)而言的。另外一种工艺是 利用异性导电胶(ACF)来装配倒装晶片。预先在基板上施加异性导电胶,贴片头用较高压力将元件贴装在基板 上,同时对元件加热,使导电胶固化。该工艺要求贴片机具有非常高的精度,同时贴片头具有大压力及加热功能 。对于非C4元件(其焊凸材料为Au或其他)的装配,趋向采用此工艺。这里,我们主要讨论C4工艺,表1列出的 是倒装晶片的焊凸材料与基板连接的几种方式。
表1 倒装晶片的焊凸材料与基板连接方式
倒装晶体装配工艺流程如图2和图3所示。
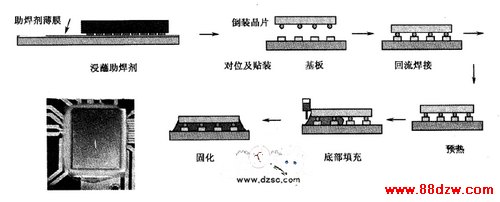
图1 倒装晶片装配工艺流程(助焊剂浸蘸与流动性底部填充)
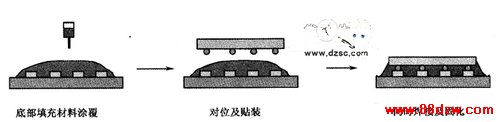
图2倒装晶片装配工艺流程(非流动性底部填充)
欢迎转载,信息来源www.88dzw.com(www.88dzw.com)
- 上一篇:倒装晶片的定义
《倒装晶片的组装工艺流程》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的组装工艺流程
- 在谷歌中搜索相关文章:倒装晶片的组装工艺流程
- 在soso中搜索相关文章:倒装晶片的组装工艺流程
- 在搜狗中搜索相关文章:倒装晶片的组装工艺流程




 当前位置:
当前位置: