现代功率模块及器件应用技术
[09-13 17:03:49] 来源:http://www.88dzw.com 控制技术 阅读:8374次
文章摘要: 在大多数情况下,人们采用图2和图4所示的垂直式结构。在这里,栅极和源极(MOSFET)或发射极(IGBT)均位于芯片上表面,而芯片底面则构成了漏极(MOSFET)或集电极(IGBT)。负载电流在沟道之外垂直通过芯片。 在图2所示的功率MOSFET和图4所示的IGBT具有平面式栅极结构,也就是说,在导通状态下,导电沟道是横向的(水平的)。 平面栅极(在现代高密度晶体管中更发展为双重扩散栅极)仍是目前功率MOSFET和IGBT中占统治地位的栅极结构。 平面式MOSFET和IGBT结构是从微电子技术移植而来的,其漏极或集电极由n+(MOSFET)或p+(IGBT)井区构成,
现代功率模块及器件应用技术,标签:计算机控制技术,工厂电气控制技术,http://www.88dzw.com在大多数情况下,人们采用图2和图4所示的垂直式结构。在这里,栅极和源极(MOSFET)或发射极(IGBT)均位于芯片上表面,而芯片底面则构成了漏极(MOSFET)或集电极(IGBT)。负载电流在沟道之外垂直通过芯片。
在图2所示的功率MOSFET和图4所示的IGBT具有平面式栅极结构,也就是说,在导通状态下,导电沟道是横向的(水平的)。
平面栅极(在现代高密度晶体管中更发展为双重扩散栅极)仍是目前功率MOSFET和IGBT中占统治地位的栅极结构。
平面式MOSFET和IGBT结构是从微电子技术移植而来的,其漏极或集电极由n+(MOSFET)或p+(IGBT)井区构成,位于芯片表面。负载电流水平地流经芯片。借助于一个氧化层,n区可以与衬底相互隔离,从而有可能将多个相互绝缘的MOSFET或IGBT与其他结构一起集成于一个芯片之上。
由于平面式晶体管的电流密度仅能达到垂直式结构的30%,因而明显地需要更多的安装面积,所以,它们主要被用在复杂的单芯片电路中。
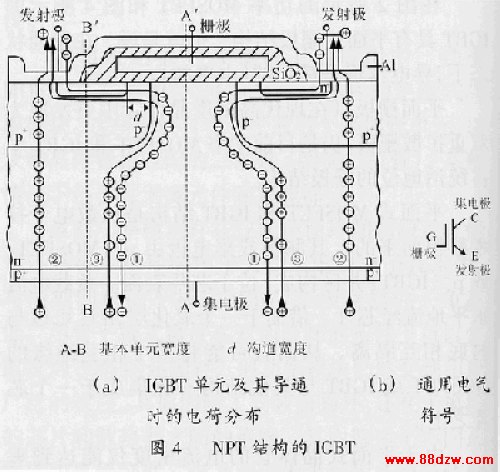
从构造上来看,功率MOSFET(图2)以及IGBT(图4)由众多的硅微单元组成。每cm2芯片上的单元数可达8.2×105(最新的耐压为60V的MOSFET)以及1×105(高耐压IGBT)。
图2、图4显示了MOSFET和IGBT具有相似的控制区结构。
n-区在截止状态下构成空间电荷区。p导通井区被植入其内,它在边缘地带的掺杂浓度较低(p-),而在中心地带则较高(p+)。
在这些井区里存在着层状的n+型硅,它们与源极端(MOSFET)或发射极端(IGBT)的金属铝表面相连。在这些n+区之上,先是植入一层薄的SiO2绝缘层,然后再形成控制区(栅极),例如采用n+型多晶硅材料。
当一个足够高的正向驱动电压被加在栅极和源极(MOSFET)或发射极(IGBT)之间时,在栅极下面的p区将会形成一个反型层的(n导通沟道)。经由这个通道,电子可以从源极或发射极流向n-漂移区。
直至n-区为止,MOSFET和IGBT具有类似的结构。它们出现在第三极区,从而决定了各自不同的性能。

1.2.1 Power MOSFET
图2清楚地显示了一个n沟道增强型垂直式结构的功率MOSFET的结构和功能。图2中的栅极结构为平面式。
在MOSFET中,上述的层状结构是在一块n+导通型的硅基片上采用外延生长、植入、扩散等方法来实现的。硅基片的背面形成了漏极。
当电压在漏极和源极之间产生一个电场时,流向漂移区的电子会被吸引至漏极,空间电荷会因此而缩小。同时,漏源电压下降,主电流(漏极电流)得以流动。
因为,在漂移区内形成电流的电子全部是多子,所以,在高阻的n-区内不会出现两种载流子的泛滥。因此,MOSFET是一个单极型器件。
在低耐压的MOSFET器件中,微单元的电阻约占MOSFET的通态电阻的5%~30%。而对于高截止电压的MOSFET来说,其通态电阻的约95%由n-外延区的电阻所决定。
上一页 [1] [2] [3] [4] [5] [6] [7] [8] 下一页
- 上一篇:三相异步电动机绕组故障分析和处理
《现代功率模块及器件应用技术》相关文章
- › 现代功率模块及器件应用技术
- 在百度中搜索相关文章:现代功率模块及器件应用技术
- 在谷歌中搜索相关文章:现代功率模块及器件应用技术
- 在soso中搜索相关文章:现代功率模块及器件应用技术
- 在搜狗中搜索相关文章:现代功率模块及器件应用技术




 当前位置:
当前位置: