现代功率模块及器件应用技术
[09-13 17:03:49] 来源:http://www.88dzw.com 控制技术 阅读:8374次
文章摘要: 目前,除了图4所显示的非穿通结构之外,穿通型结构(PT=Punch Through)的IGBT也得到了应用。最初的IGBT就是基于后者而形成的。 两种结构的基本区别在于,在PT型IGBT的n-和p+区之间存在一个高扩散浓度的n+层(缓冲层)。另外,两者的制造工艺也不同。 在PT型IGBT中,n+和n-层一般是在一块p型基片上外延生长而成。而NPT型IGBT的基本材料是一块弱扩散的n型薄硅片,在其背面植入了集电极端的p+区。两种IGBT的顶部结构相同,均为平面式的MOS控制区。 图5比较了两种IGBT的构造及其正向截止状态下的电场强度分布
现代功率模块及器件应用技术,标签:计算机控制技术,工厂电气控制技术,http://www.88dzw.com目前,除了图4所显示的非穿通结构之外,穿通型结构(PT=Punch Through)的IGBT也得到了应用。最初的IGBT就是基于后者而形成的。
两种结构的基本区别在于,在PT型IGBT的n-和p+区之间存在一个高扩散浓度的n+层(缓冲层)。另外,两者的制造工艺也不同。
在PT型IGBT中,n+和n-层一般是在一块p型基片上外延生长而成。而NPT型IGBT的基本材料是一块弱扩散的n型薄硅片,在其背面植入了集电极端的p+区。两种IGBT的顶部结构相同,均为平面式的MOS控制区。
图5比较了两种IGBT的构造及其正向截止状态下的电场强度分布。
对于一个PT型IGBT或者IGET(E:外延生长式结构Epitaxial structure)来说,在正向截止状态下,空间电荷区覆盖了整个n-区。为了使生长层即使在高截止电压下还是尽可能的薄,在n-漂移区的结尾处,其电场强度需要用高扩散浓度的n+缓冲层来减弱。
反之,对于NPT型IGBT或IGHT(H:同质式结构Homogenous structure)来说,它的n-漂移区具有足够的厚度,以至于可以吸收在正向截止状态下最大截止电压的场强。因此,在允许的工作范围内,电场延伸至整个n-区之外的现象(穿通)是不会发生的。
为了进一步描述IGBT的功能以及PT和NPT型器件的不同特性,有必要来观察由IGBT结构而导出的等效电路〔图6(b)〕。类似于图3,可得到图6中所示的寄生电容和电阻的起源与符号,如表2所列。
表2 IGBT的寄生电容及电阻

撇开器件内部的电容和电阻不谈,IGBT的等效电路含有同样存在于MOSFET结构中的理想MOSFET,以及一个寄生npn晶体管,即n+发射区(发射极)/p+井区(基极)/n漂移区(集电极)。在这个寄生结构里,位于发射极之下的p+井区的电阻被视为基极-发射极电阻RW。此外,下列区域组合构成了一个pnp晶体管,即p+集电极区(发射极)/n-漂移区(基极)/p+井区(集电极)。这个pnp晶体管与上面的npn晶体管一起构成了一个晶闸管结构。
这一寄生晶闸管的锁定效应(Latch up)可能会出现于导通状态(前提是某临界电流密度被超过,该临界值随芯片温度的增加而减小),也可以在关断时发生(动态锁定,由比通态运行时更高的空穴电流所引起)。后者发生的条件是式(3)被满足
M(αnpn+αnpn)=1(3)
式中:M为乘法系数;
αpnp,αnpn=αTγE,为单只晶体管的共基极电流增益,
αT为基极传输系数;
γE为发射极效率。
锁定的出现会导致IGBT失控,直至损坏。
对于当代的IGBT,采用下述的设计措施,可以在所有允许的静态和动态运行条件下有效地防止锁定效应的出现。例如,通过合理的设计,在关断时动态锁定所需的电流密度可达额定电流的15倍之多。
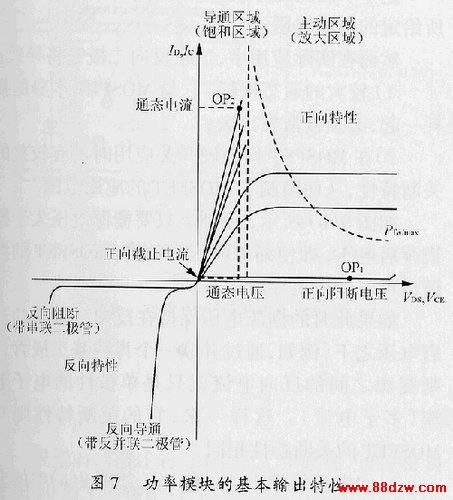
图7
为此,晶体管的基极-发射极电阻可以通过下列措施减到如此的小,以至于在任何允许的运行状态下,都不可能达到该npn晶体管的基极-发射极二极管的开启电压。这些措施是,
上一页 [1] [2] [3] [4] [5] [6] [7] [8] 下一页
- 上一篇:三相异步电动机绕组故障分析和处理
《现代功率模块及器件应用技术》相关文章
- › 现代功率模块及器件应用技术
- 在百度中搜索相关文章:现代功率模块及器件应用技术
- 在谷歌中搜索相关文章:现代功率模块及器件应用技术
- 在soso中搜索相关文章:现代功率模块及器件应用技术
- 在搜狗中搜索相关文章:现代功率模块及器件应用技术




 当前位置:
当前位置: