倒装晶片的组装基板的设计及制造
[09-12 18:47:41] 来源:http://www.88dzw.com PCB设计 阅读:8599次
文章摘要:基板技术是倒装晶片工艺需要应对的最大挑战。因为尺寸很小(小的元件,小的球径,小的球间距,小的贴装 目标),基板的变动可能对制程良率有很大影响:・密间距贴装良率极易受限于阻焊膜和焊盘的尺寸公差;・由于尺寸通常很小,对基板的变形非常敏感;・基板焊盘的表面处理直接影响焊接性能和可靠性;・基板的厚度也影响到产品的可靠性;・由于暴露在周围环境中,水汽在基板内会导致阻焊膜和碾压层分层;・使用前需要烘烤,影响整个工艺流程;・储存环境需要干燥;・设计师必须在基板成本、制造技术、产品功能、供应商制程能力和良率之间找到平衡点。基板材料一般为硬质板和柔性电路板,还有其他的一些基板材料选择,如表1所示。较普遍的使用玻
倒装晶片的组装基板的设计及制造,标签:pcb培训,pcb是什么,pcb软件,http://www.88dzw.com基板技术是倒装晶片工艺需要应对的最大挑战。因为尺寸很小(小的元件,小的球径,小的球间距,小的贴装 目标),基板的变动可能对制程良率有很大影响:
・密间距贴装良率极易受限于阻焊膜和焊盘的尺寸公差;
・由于尺寸通常很小,对基板的变形非常敏感;
・基板焊盘的表面处理直接影响焊接性能和可靠性;
・基板的厚度也影响到产品的可靠性;
・由于暴露在周围环境中,水汽在基板内会导致阻焊膜和碾压层分层;
・使用前需要烘烤,影响整个工艺流程;
・储存环境需要干燥;
・设计师必须在基板成本、制造技术、产品功能、供应商制程能力和良率之间找到平衡点。
基板材料一般为硬质板和柔性电路板,还有其他的一些基板材料选择,如表1所示。较普遍的使用玻纤加强的 FR-4环氧树脂材料,BT树脂材料是另外一种选择,有溴化物添加其中,要考虑对环境的影响。
柔性电路板的材料一股为聚酰亚胺,其粘贴在铜线路上。由于制造工艺的问题,往往会有胶水被“挤出”,在 组装工艺中会产生大量气泡的现象,如图1所示。
(1)阻焊膜
阻焊膜一股以液态定影技术获得(LPI),也可以使用干膜法。典型的LPI材料有TaiyoPSR 4000(Aus303,Aus5……),Enthone DSR3421和Probinmer 65/74/77。不同的获得方式其厚度会不太一样 ,采用“沟槽”方式的厚度0.4~0.7 mil,一般为1~2 mil。SMD方式会有较厚的阻焊膜,厚的阻焊膜会减小晶 片下的间隙,从而影响底部填充工艺及可靠性,同时厚的阻焊膜会增加“阻焊膜阴影效应”,影响装配良率。
表1 基极材料选择表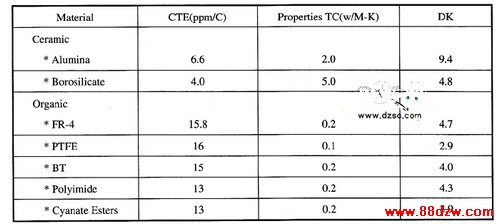
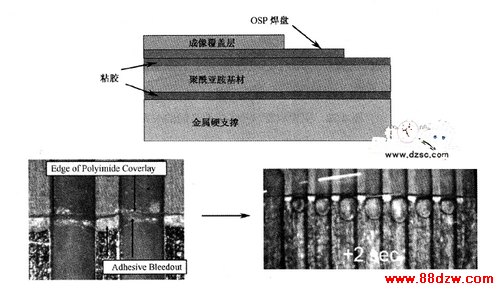
图1 回流焊接过程中产生气泡
阻焊膜的开孔设计和制造精度对装配良率及可靠性有非常大的影响。通常阻焊膜在铜箔上窗口精度为±3 mil@ 3 slgma,比较好的可以控制在±2 mil,而对于软板其精度会差些,在±4 mil,有时会更差。通常,阻焊膜会 有一定程度的偏移,如图2所示,会影响到贴装的精度。

图2 阻焊膜偏移导致贴片干涉及误差
阻焊膜窗口设计时要考虑以下因素:
・阻焊膜窗口尺寸公差――SMtol;
・阻焊膜位置公差――SMre;
・贴片偏差――PMpe。
不考虑阻焊膜厚度的影响,其窗口尺寸与各偏差之间的关系如图3所示。
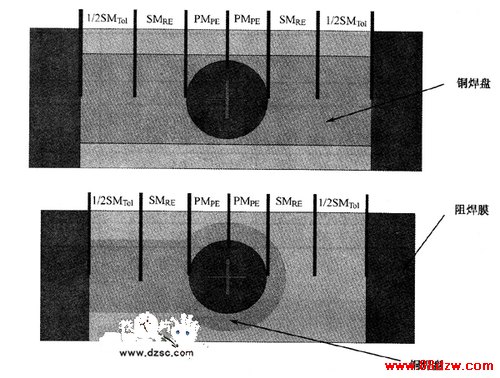
图3 阻焊膜窗口与各偏差之间的关系
如果考虑阻焊膜的厚度,我们必须要注意阻焊膜“阴影效应”。由于它的存在,使得焊球在回流焊接过程中不 能完全接触焊盘而形成完整的“可控坍塌连接”,导致焊点内应力的或者电气连接问题。
在图4中,Mt为铜箔上阻焊膜厚度;Bd为焊球直径;MShadow为阴影区,焊球不能接触焊盘。
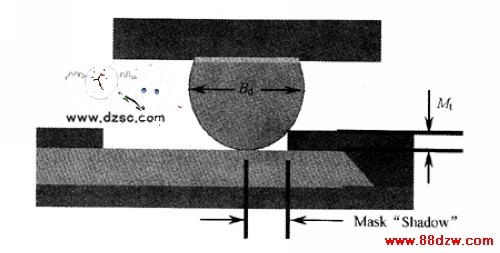
图4 阻焊膜“阴影效应”示意图
为了消除阻焊膜“阴影效应”的影响,需要适当加大阻焊膜的窗口。
《倒装晶片的组装基板的设计及制造》相关文章
- › 倒装晶片的回流焊接及填料固化后的检查
- › 倒装晶片的非流动性底部填充工艺
- › 倒装晶片的底部填充工艺
- › 倒装晶片的组装焊接完成之后的检查
- › 倒装晶片的组装的回流焊接工艺
- › 倒装晶片的贴装工艺控制
- 在百度中搜索相关文章:倒装晶片的组装基板的设计及制造
- 在谷歌中搜索相关文章:倒装晶片的组装基板的设计及制造
- 在soso中搜索相关文章:倒装晶片的组装基板的设计及制造
- 在搜狗中搜索相关文章:倒装晶片的组装基板的设计及制造




 当前位置:
当前位置: